技術區別
TSV硅通孔(Through Silicon Via),指連接硅晶圓兩面并與硅襯底和其他通孔絕緣的電互連結構。
硅中介層有TSV的集成是最常見的一種2.5D集成技術,芯片通常通過MicroBump和中介層相連接,作為中介層的硅基板采用Bump和基板相連,硅基板表面通過RDL布線,TSV作為硅基板上下表面電氣連接的通道。
這種2.5D集成適合芯片規模比較大,引腳密度高的情況,芯片一般以FlipChip形式安裝在硅基板上。
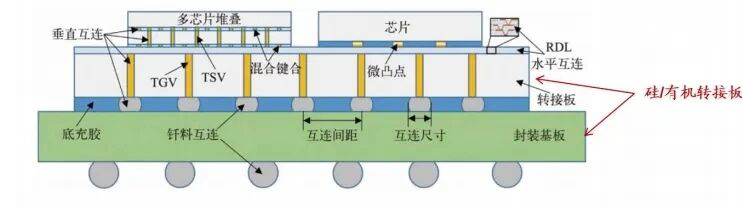
TSV技術
TGV玻璃通孔(Through Glass Via),是通過在玻璃基板上制作垂直貫通的微小通孔,并在通孔中填充導電材料(CU),從而實現不同層面間的電氣連接。
TGV以高品質硼硅玻璃、石英玻璃為基材,通過種子層濺射、電鍍填充、化學機械平坦化、RDL再布線, bump工藝引出實現3D互聯,被視為下一代先進封裝集成的關鍵技術。
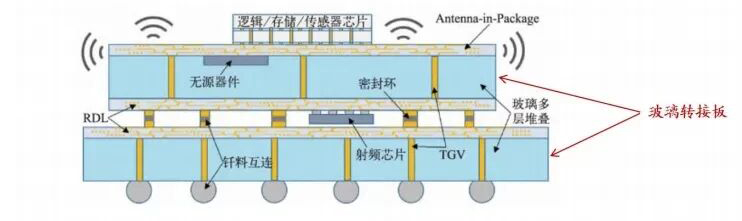
TGV技術
形象比喻
TSV是在“實心混凝土”(硅)里鑿電梯井,而TGV則是在“透明玻璃”里鋪設地鐵隧道。玻璃本身是高度絕緣的,所以這條“隧道”天生就擁有更干凈、更高速的通行環境。

切割難點
不論是TSV還是TGV,都需要再晶圓級封裝后分離出獨立封裝單元,滿足后續組裝需求。
TSV 器件通常由硅基板、金屬填充層(銅為主)、介電絕緣層(如 SiO?)、堆疊鍵合層(如聚合物膠)組成,不同材料的物理特性差異導致切割過程易產生缺陷。
TGV 常用于高頻芯片、MEMS 傳感器的小型化封裝,常用厚度小于100μm 的超薄玻璃基板,基于整片玻璃晶圓的切割分離,因為其脆性、硬度及熱穩定性直接導致切單難度顯著高于TSV。以2.5D 封裝的TGV轉接板為例,切割線與邊緣通孔的距離通常需控制在 10μm 以內,對切割設備的定位精度和切割刀具的切割精度都有極高要求。
具體切割方案歡迎咨詢西斯特劃片刀應用團隊